 ③特殊加工工程
③特殊加工工程
用途に応じて行われる、ウェーハの特殊加工
当社ではお客さまのご要望に応じて、ポリッシュト・ウェーハをさらに特殊加工し、以下4つのウェーハを製造しています。
用途に応じた4つの特殊加工
アニール・ウェーハ(Annealed Wafer)
ポリッシュト・ウェーハを水素もしくはアルゴン雰囲気中で高温熱処理(アニール処理)。表面の酸素を除去することによって、結晶完全性を高めたウェーハです。

エピタキシャル・ウェーハ(EW:Epitaxial Wafer)
ポリッシュト・ウェーハをエピタキシャル炉の中で約1200℃まで加熱。炉内に気化した四塩化珪素(SiCl4)、三塩化シラン(トリクロルシラン、SiHCl3)を流すことで、ウェーハ表面上に単結晶シリコンの膜を気相成長(エピタキシャル成長)させます。結晶の完全性が求められる場合や、抵抗率の異なる多層構造を必要とする場合に対応できる高品質なウェーハです。

埋込層付エピタキシャル・ウェーハ(JIW:Junction Isolated Wafer)
お客さまの設計に合わせて、露光・イオン注入・熱拡散技術を利用。表面にあらかじめIC用の埋め込み層を形成した後、エピタキシャル成長させたウェーハです。
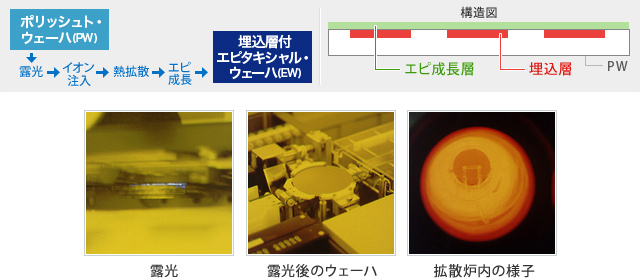
SOIウェーハ(Silicon-On-Insulator Wafer)
支持基盤(Handle Wafer)と、半導体デバイスを作り込む活性基板(Active Wafer)のどちらか一方、もしくは両方に酸化膜を形成し、二枚を貼り合わせて熱処理することで結合。その後、活性基板を所定の厚さまで研削・研磨します。
電気絶縁性の高い酸化膜層をウェーハ内部に形成させることで、半導体デバイスの高集積化、低消費電力化、高速化、高信頼性を実現したウェーハです。必要に応じて、活性層にヒ素(As)やアンチモン(Sb)の拡散層を形成することも可能です。

